Физика туннельного диода
В случае внешнего напряжения обратной полярности внутӯренний потенциальный барьер увеличится (рис. 3,е), препятӯствуя диффузии основных носителей, и диод будет заперт. Основными называются носители, определяющие тип проводиӯмости полупроводника, т. е. электроны для n-материала и дырӯки для p-материала.
Но в каждом из этих полупроводников, кроме основных носителей, имеются еще и носители противоӯположного знака, которые называются неосновными.
Это дырӯки в электронном полупроводнике и электроны в дырочном полупроводнике. Причиной их появления служит тепловая. генерация, создающая носители обоих знаков и наличие в каждом полупроводнике, кроме определяющей примеси (донорной для л-материала и акцепторной для p-материала), еще и небольшого количества примеси противоположного харакӯтера (из-за несовершенной очистки материала). Так как для неосновных носителей обратное смещение на переходе будет пропускным, то через переход будет течь небольшой обратный ток, величина которого определяется концентрацией неӯосновных носителей в полупроводнике. Она может быть опреӯделена из соотношения, полученного следующим образом.
В состоянии теплового равновесия динамические процессы тепловой генерации пар уравновешиваются процессами рекомӯбинации. Скорость тепловой генерации при неизменной темӯпературе постоянна и не зависит от характера полупроводниӯка (электронный или дырочный). Скорость рекомбинации в собственном полупроводнике пропорциональна произведению плотностей носителей, т. е. пропорциональна величине
ni·pi=ni2 , так как ni = pi ,
где ni и pi—соответственно концентрации электронов и дырок в собственном полупроводнике. Величина ni2 постоянна для данного типа полупроводника и зависит только от температуры При комнатной температуре для германия ni2= (2·1013)2 см−3 для кремния ni2= (1,4·1010)2 см−3. В примесном полупроводӯнике скорость рекомбинации не изменится по сравнению со скоростью рекомбинации в собственном полупроводнике, поӯтому что в обоих случаях они уравновешиваются равными по скоростям процессами тепловой генерации, а так как скорость рекомбинации пропорциональна произведению плотностей ноӯсителей,то
pp·np= nn·pn = ni·pi= ni2,
где pp·np — соответственно концентрации дырок в дырочном полупроводнике и электронов в электронном полуӯпроводнике, т. е. концентрации основных носитеӯлей;
nn·pn —соответственно концентрации электронов в дырочӯном полупроводнике и дырок в электронном полуӯпроводнике, т. е. концентрации неосновных носиӯтелей. Отсюда по известной концентрации основных носителей нужно определить плотность неосновных носителей, а значит и величину обратного тока p-n-перехода.
Вырожденные полупроводники.
Рассмотренные выше полупроводники, идущие на изготовӯление большинства обычных полупроводниковых приборов, имеют концентрацию легирующих примесей порядка 1014 — 1018см−3. Дальнейшее повышение количества примеси приводит к качественным изменениям свойств полупроводниӯковых материалов, которые необходимо рассмотреть. Знание свойств таких сильнолегированных материалов очень важно, потому что они служат основой для изготовления туннельных диодов.
В обычных полупроводниках атомы примеси, произвольно расположенные в исходном материале, достаточно удалены друг от друга, так что между собой не взаимодействуют. На энергетической диаграмме это отображается расположением отдельных, не расщепленных в зону энергетических уровней электронов примесных атомов. Вследствие локализованности этих уровней электроны, находящиеся на них, не могут переӯмещаться по кристаллу и участвовать таким образом, в элекӯтропроводности.
По мере увеличения концентрации примесей расстояния между их атомами уменьшаются, что увеличивает взаимодейӯствие между ними. Это приводит к расщеплению примесных уровней в примесную зону, которая может слиться с основной зоной (зонной проводимости для примесной зоны доноров или с валентной зоной для примесной зоны акцепторов). Такое слияние зон происходит при концентрациях примеси, превышающих, некоторое критическое значение. Так, для германия значение этой концентрации составляет около 2·1019 см−3, а для кремния — 6·1019 см−3. Такие сильнолегированные полупроводники относятся к типу вырожденных, отличительной чертой которых является то, что уровень Ферми находится внутри либо зоны проводимости, либо валентной зоны.
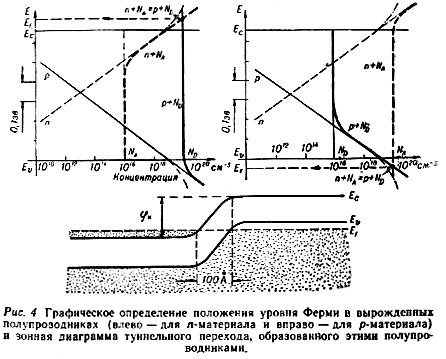 |
Энергетическая диаграмма p-n-перехода, образованного вырожденным электронным и дырочным полупроводниками, показана на рис. 4. Так как уровни Ферми в обеих частях полупроводника в состоянии термодинамического равновесия должны сравняться, то выполнение этого условия приводит к перекрытию зон. Дно зоны проводимости электронной области получается ниже потолка валентной зоны дырочного полуӯпроводника и, как видно из рис. 4, величина контактной разноӯсти потенциалов φk при контакте двух вырожденных полупроӯводников будет близка к ширине запрещенной зоны Eg=(Ec — Еv) исходного материала [так как (EF — Еc) и (EV — ЕF)<<Eg то Eg ≈ e· φk]. Ширина p-n-перехода обратно пропорӯциональна концентрации примесей, и при концентрациях, соӯответствующих вырождению (1019—1020 см−3), ширина пеӯрехода получается порядка 100 А°.
Перейти на страницу: 1 2 3 4 5 6 7 8 9 10 11
